Unser Fokus liegt auf Messtechniken, die es ermöglichen das Wachstum dünnster Schichten während der Schichtherstellung in situ und in Echtzeit zu überwachen. Beschichtungsprozesse, wie Atomic Layer Deposition (ALD), Chemical Vapor Deposition (CVD) und Physical Vapor Deposition (PVD), können dadurch schneller entwickelt und charakterisiert sowie besser kontrolliert werden. Hierfür geeignete Messtechniken sind insbesondere die Schwingquarzmesstechnik und die spektroskopische Ellipsometrie. Beide Messtechniken sind in der Lage Sub-Monolagen dünnster Schichten zu detektieren und bieten verschiedene Vor- und Nachteile.
Schwingquarzmesstechnik – Quartz Crystal Microbalance (QCM)
Die Schwingquarzmesstechnik verwendet oszillierende Kristallscheiben, deren Resonanzfrequenz durch die Anlagerung von Schichtmaterial verändert wird. Die mit mehreren Megahertz schwingenden Sensoren reagieren bereits auf kleinste Änderungen der Massenbelegung und können dadurch dünnste Oberflächenbelegungen zuverlässig detektieren. Die Schwingquarze können in Messköpfe eingebaut und so dauerhaft in die Beschichtungsanlage integriert oder flexibel in dieser platziert werden. Durch die Verwendung von Messköpfen mit mehreren Sensoren können verschiedene Messpositionen gleichzeitig überwacht werden, was Aussagen über das lokale Schichtwachstum ermöglicht.
- Hohe Schichtdickenauflösung (< 0,01 nm detektierbar)
- Hohe Abtastrate (bis zu 10 Messungen pro Sekunde)
- Nur Schichtwachstum auf Vorbeschichtung beobachtbar
- Einfache Datenverarbeitung und -auswertung
- Anzahl der Messpunkte anpassbar
- Kompatibel zu verschiedensten Beschichtungsanlagen und -prozessen
- Geringe Kosten für Anschaffung und Betrieb
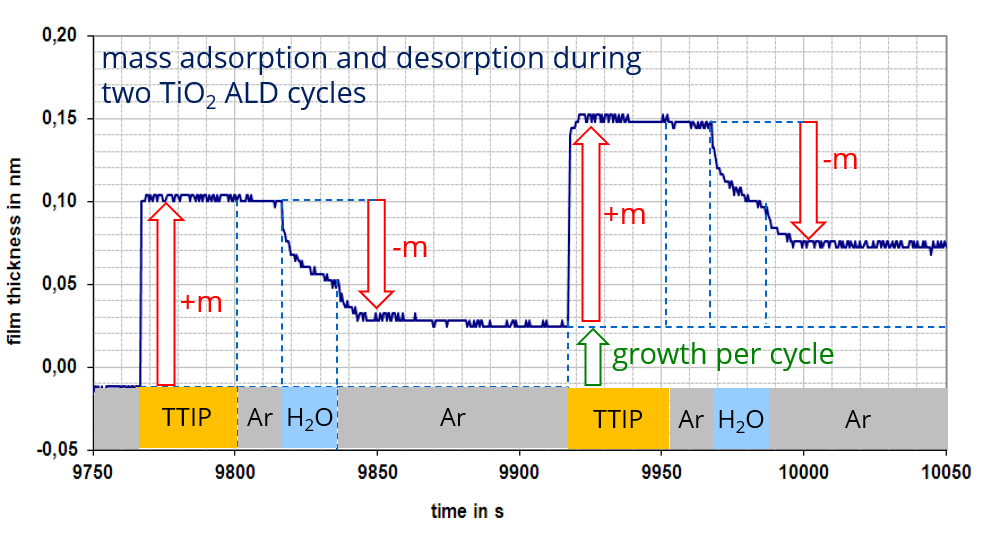
Spektroskopische Ellipsometrie – Spectroscopic Ellipsometry (SE)
Die Spektroskopische Ellipsometrie hat sich weltweit als bevorzugte Methode zur Bestimmung der Dicke dünnster Schichten etabliert. Als ex situ Messtechnik bietet sie viele Vorteile, lässt sich flexibel einsetzen und kann ortsaufgelöste Messdaten liefern. Beim Einsatz als in situ Messtechnik muss die Beschichtungsanlage für den Anbau von Lichtquelle und Detektor vorbereitet und eine Sichtverbindung zum zu beschichtenden Substrat vorhanden sein. Außerdem müssen die Ein- und Austrittsfenster mittels Ventilen oder Spülgasen vor der Beschichtung geschützt werden. Sofern diese Anforderungen erfüllt sind, können die optischen Eigenschaften wachsender Schichten während ihrer Herstellung gemessen und zur Bestimmung von Schichtdicken und anderen Größen verwendet werden.
- Hohe Schichtdickenauflösung (< 0,01 nm detektierbar)
- Ausreichende Abtastrate (bis zu einer Messung pro Sekunde)
- Schichtwachstum auf verschiedensten Substraten beobachtbar
- Komplizierte modellbasierte Datenverarbeitung und -auswertung
- Eine festgelegte Messposition
- Kompatible Beschichtungsanlage notwendig
- Hohe Kosten für Anschaffung und Betrieb